FCP���bоƬ���bͨ�������ξߣ����ܶȻ�(li��n)�r���Ŀɿ��Խ�Q����
�S��AIоƬ��5Gͨ���O�䌦���b�ܶȺͿɿ��Ե�Ҫ��ͻ�Ƃ��y(t��ng)�O�ޣ�F(xi��n)CP��Flip Chip Package�����bоƬ���g(sh��)�ѳɞ��а댧�w�ĺ��ķ��b������Ȼ�������ܶȺ��c��С�g���_80��m���c���s����ѯB�Y(ji��)��(g��u)��ʹ�÷��b�w�ڳ����}�F���Ȑ��ӭh(hu��n)�������R��������(zh��n)��

�|ݸ·�ǿƼ��Ƴ���FCPͨ�������ξ������鵹�bоƬ���b�OӋ��ͨ�^���τ�(chu��ng)���c��ˇ�m�䣬���F(xi��n)���o�����c���a(ch��n)Ч�ܵ�ƽ�⡣
һ�����g(sh��)ʹ�c�c��Q����
���c�����������bоƬ���a��/�~�cֱ�ӱ�¶�ڭh(hu��n)�������y(t��ng)���������º��c�������С����ξ߲��ü{�����ЙC���֬��CTE������Ûϵ��(sh��)���c����ƥ�������40%����(j��ng)2000�Μض�ѭ�h(hu��n)�yԇ�o�_�ѡ�
�߾���Ϳ��������ᘌ�65��65mm��ߴ���b��������c�z�y�cҕ�X��λϵ�y(t��ng)�����F(xi��n)��25��m��Ϳ�����ȣ����⺸���·��
��ˇ��������֧�ֻ�������ֱ��Ϳ�����m��FCBGA��FCCSP���������b��ʽ������������99.2%��
�������ĸ�����(y��u)��
����ͻ�����_�l(f��)�ĵͽ�늳���(sh��)��Dk<3.5�����o�ӣ��p����̖��ݔ�p�ģ��M��7nmоƬ�ĸ��l����
�ɱ���(y��u)�����δ�Ϳ�����w���_98%���^���y(t��ng)��ˇ��(ji��)ʡ30%�������ġ�
�h(hu��n)���J�C��ͨ�^RoHS�cREACH�˜ʣ��o�U�䷽������܇���AEC-Q100Ҫ��
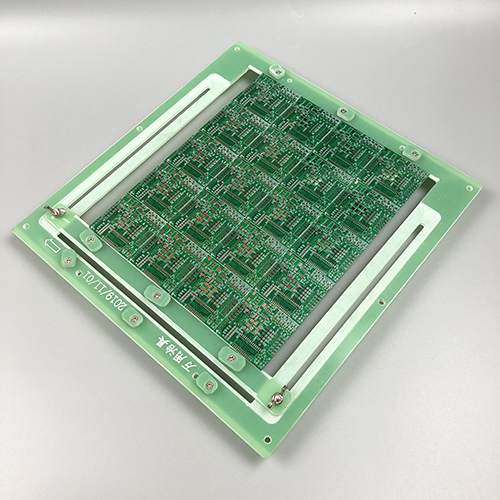
�������͑��È���
��(sh��)��(j��)����HPCоƬ����Q��оƬ�ѯB���µľֲ��^�ᆖ�}������ϵ��(sh��)�_1.8W/m��K��
܇Ҏ(gu��)������������ͨ�^ISO 16750-4�}�F�yԇ�����o�������L��15�ꡣ
�ɴ����O��������Ϳ���ӣ���ȡ�15��m���m��100��m����оƬ���b��
�ġ��͑�rֵ
�ɿ���������������a(ch��n)ƷʧЧ�ʽ�����50ppm��MTTF��ƽ���o���ϕr�g������3����
���a(ch��n)��Ч��ģ�K���OӋ֧�ֿ��ٓQ�ͣ��ξ��ծa(ch��n)���_2000Ƭ��
���Ʒ������ṩDOE����c������C���M��͑��������

